ABSTRACT
Chemical Mechanical Planarization (CMP) is an essential process for flattening the surface of the wafer to produce a fine structure. The CMP process is performed after a break-in step prior to optimizing the polishing pad. Break-in consists of the conditioning step and warming-up step. In the conditioning step, a conditioner embedded with diamonds is used to remove residues from the pad surface and manages the directionality and height deviation of asperities on the surface. The warming-up step serves to increase the temperature of the pad surface by polishing multiple wafers. The temperature in the warming-up step is raised due to friction between the wafer and pad, and the pad state is divided into a partly warmed up section, a transition section, and a fully warmed up section of the pad. In this study, as the wafer pressure increased in the warm-up stage, the time for the pad to reach the stable section was confirmed, and the break-in mechanism was analyzed in terms of surface characteristics and mechanical properties, such as surface photograph, surface roughness of the pad, and elastic modulus of pad asperities. Based on these results, the break-in mechanism that increases the material removal rate was analyzed.
-
KEYWORDS: Chemical mechanical planarization, Pad asperity, Temperature, Break-in, Real contact area
-
KEYWORDS: 화학적 기계적 평탄화, 패드 돌기, 온도, 브레이크 인, 실 접촉 면적
1. 서론
반도체 제조에는 실리콘 성장, 리소그래피, 에칭, CMP, 이온 주입 등 복잡한 공정과 높은 수준의 기술이 필요하다.
1 그 중 특히 CMP (Chemical Mechanical Planarization) 공정은 웨이퍼 표면을 평탄화하여 미세 구조를 형성하는데 없어서는 안될 공정이다. CMP는 슬러리에 의한 화학적 반응과 웨이퍼와 CMP 연마 패드의 상대 속도 및 마찰에 의한 기계적 제거로 인해 연마가 진행된다. CMP 공정의 소모품 중 하나인 연마 패드는 표면에 있는 홈을 통해 슬러리의 이동을 돕고 미세 돌기는 연마 입자를 운반하는 역할을 한다.
2 연마 패드는 다공성 구조인 폴리우레탄 재질로써 표면에는 많은 돌기와 슬러리의 이동을 돕는 기공이 있다.
CMP 공정은
Fig. 1과 같이 브레이크 인(Break-In)이라는 실제 CMP 공정 전 연마 패드를 최적의 상태로 만드는 사전 단계를 거친 후에 진행된다. 동일한 연마 조건을 사용함에도 불구하고 초기 웨이퍼와 나머지 웨이퍼 사이의 재료 제거율 변화인 ‘첫 번째 웨이퍼 효과(The First Wafer Effect)’가 발생하기 때문에 재료제거율 향상을 위해서는 새 연마 패드의 표면을 적절하게 처리해주어야 한다.
3 브레이크 인은 다이아몬드가 박혀있는 컨디셔너로 패드 표면의 잔류물 제거, 표면의 돌기를 관리하여 초기에 상대적으로 부드러운 표면에 비해 거칠게 만들어주고 돌기의 형상을 일정하게 해주는 오랜 컨디셔닝(Heavy Conditioning) 단계와 다수 웨이퍼 연마로 정상 상태 연마를 향상시키기 위한 워밍업(Warming-Up) 단계, 워밍업 이후 마모된 돌기를 재생시켜주어 실제 CMP 공정을 진행하기 위한 짧은 컨디셔닝(Light Conditioning) 단계로 이루어져 있다. 하지만 연마 패드의 브레이크 인 시간이 기업마다 다르고 방식에 대한 메커니즘이 명확하지 않다.
4
Fig. 1 Schematic of break-in step
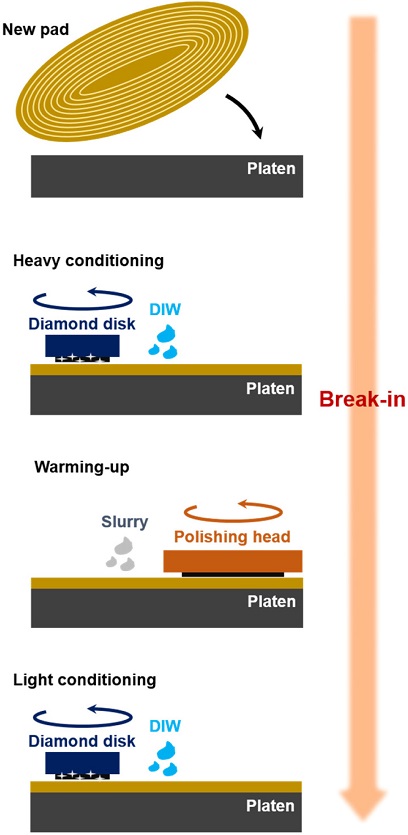
이에 대해 Jeong
3은 브레이크 인 시간 단축의 목적으로 연마 패드 표면 상태, 슬러리 효과, 웨이퍼 효과에 대해 표면 거칠기가 높고 실리콘 웨이퍼를 사용하는 것이 패드의 안정화 및 브레이크 인 시간 단축 방안에 대한 내용을 패드 표면 온도와 마찰력을 이용하여 제시하였다. 또한, Park
5은 다이아몬드 그릿의 무작위한 분포를 가지는 컨디셔너와 균일한 분포를 가지는 컨디셔너에 따라 균일한 표면 거칠기를 가지는 패드에서 참여 입자 개수가 많기 때문에 높은 재료제거율을 가짐을 정의하였다. Vasilev. B
6는 컨디셔너의 다이아몬드 밀도, 높이, 직경이 다른 컨디셔너를 시간에 따른 연마 패드 돌기의 반경 및 높이 분포를 파악하고 재료제거율 모델을 도출하였다.
하지만 CMP 공정에서 웨이퍼와 패드의 마찰에 의해 생성되는 온도는 재료제거율에 영향을 미치는 요인들 중 하나이다.
7 그러나 앞서 언급한 선행 연구에서는 온도에 따른 패드의 기계적 특성 및 표면의 변화에 대응할 수 없다. 따라서 본 연구에서는 브레이크 인 중 워밍업 조건에 따라 패드의 최적화 도달 시간과 워밍업 시 발생하는 마찰 온도가 연마 패드에 미치는 영향을 확인하고 브레이크 인 메커니즘에 대한 분석을 하고자 한다.
2. 이론적 배경
2.1 기계적 재료제거 메커니즘
CMP 공정은 화학 용액인 슬러리에 의해 웨이퍼 표면에 화학 반응층이 형성되고, 웨이퍼와 연마 패드의 상대 회전에 의한 기계적 제거로 연마가 이루어진다. CMP 공정의 지배방정식인 프레스톤 방정식(Preston’s Equation)에서 프레스톤 상수는 화학 및 기계적 변수, 그리고 다양한 작동 조건에 의해 결정되며, 이러한 예로써 연마 패드의 거칠기와 탄성, 패드 표면의 마모, 웨이퍼와 패드 돌기 간의 접촉 면적 등이 있다.
8 패드는 응력-변형 특성에서 고분자 고유의 성질인 점탄성 거동을 보이며, 실제 공정 중 패드의 거동 특성이 연마 결과에 영향을 미친다.
9 공초점 현미경으로 측정한
Fig. 2와 같이 연마 패드 표면에는 무작위의 높이 분포를 가지는 돌기가 있으며 웨이퍼와 연마 패드의 실제 접촉하는 면적을 실 접촉 면적(Real Contact Area, RCA)이라고 한다. Kuide Qin
10은 웨이퍼와 연마 패드 돌기의 실 접촉 면적을 Greenwood-Williamson
11 모델을 기반으로 하는 수학적 모델식을 제시하였고, 웨이퍼와 연마 패드의 복합 탄성 계수와 실접촉 면적은 반비례 관계를 나타낸다.
Fig. 2Surface profiles of polishing pad

여기서 vp, vw, Ep, Ew는 각각 패드와 웨이퍼의 푸와송 비 및 탄성 계수를 의미하고, C는 h/σ가 0.3과 0.5사이에 있을 때 0.3에서 0.4 사이의 상수이며, h는 패드와 웨이퍼의 평균 간격, σ는 돌기 높이 표준편차이다. β, σ, A0는 패드 돌기의 평균 반지름, 돌기 높이 분포의 표준 편차, 웨이퍼 면적을 의미한다.
Lee, H. S.
12은 패드의 표면거칠기에 의해 돌기마다 압입량의 차이를 고려하여 실 접촉 면적의 모델식을 개선하여 재료제거율 모델을 제안하였다. 이와 같이 공정 중 연마 패드와 웨이퍼의 실 접촉 면적에 대한 연구는 널리 이루어지고 있으나, 실 접촉 면적에 있어서 중요한 변수 중 하나인 온도에 대한 연구는 여전히 부족하다. 온도는 브레이크 인 중 워밍업 단계에서 생기는 마찰에너지에 의해 상승하고, 상승한 온도로 인해 워밍업 단계를 진행하지 않았을 때에 비해 재료제거율이 상승한다.
1장에서 언급한 바와 같이 CMP 공정 전 연마 패드를 최적의 상태로 만드는 브레이크 인은 컨디셔닝 단계와 워밍업 단계로 이루어져 있다.
Fig. 3은 각 브레이크 인 단계별 연마 패드 돌기의 상태를 나타내는 그림이다.
Fig. 3(a)는 어떤 작업도 하지 않은 패드는 무작위의 돌기를 가지고,
Fig. 3(b)에서 컨디셔닝 단계를 거치면 돌기의 거칠기, 방향성, 높이 분포가 일정해진다. 그 후 다수의 웨이퍼 연마를 이용하는 워밍업 단계가 지나고 나면
Fig. 3(c)와 같이 돌기는 마모가 일어난다. 워밍업 단계에서 패드 표면은 온도가 일부 오른(Partly Warmed Up, PWU) 구간에서 어느 시간에 도달하면 천이 구간을 거친 후 온도가 완전히 오른(Fully Warmed Up, FWU) 구간에 도달한다. 하지만 웨이퍼 압력에 따라 도달하는 시간이 다르기 때문에 패드의 최적화 예측이 어렵다. 따라서 PWU 구간과 FWU 구간의 차이를 온도와 패드 돌기 관점에서 브레이크 인이 완료된 패드 상태를 파악하고자 한다.
Fig. 3Schematics of polishing pad asperities at each break-in step
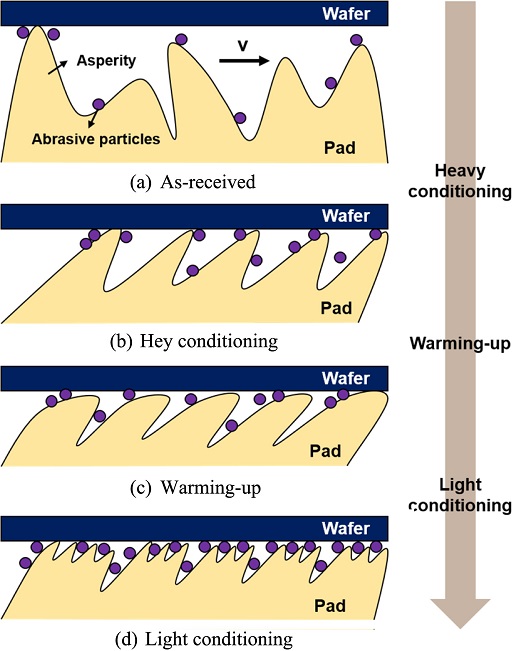
3. 브레이크 인 조건에 따른 실험 및 측정
3.1 패드 표면 측정
마찰 온도가 패드 돌기에 미치는 영향을 파악하기 위해 워밍업 단계에서 패드의 PWU 구간과 FWU 구간으로 나누어서 각각에 대한 탄성 계수 및 경도와 표면 거칠기를 측정하였다. 패드 돌기의 탄성 계수 및 경도는 Anton Paar사의 고정밀 표면 물성 분석 장치(Nano-Indenter)를 통해 하나의 샘플마다 10 포인트씩 측정하였으며, 측정 장비의 팁 반경은 2 μm이고, 7 mN의 힘으로 한 포인트당 26초간 측정하였다. 표면 거칠기는 Kosaka사의 SEF680 표면조도 측정기를 사용하여 측정하였다. 또한, 실제 패드의 표면 상태로서 돌기의 형태와 기공을 관찰하기 위해 후방산란전자 회절 패턴 분석기(Electron Backscatter Diffraction, EBSD)를 장착한 전계 방사형 주사전자현미경(Field Emission-Scanning Electron Microscope, FE-SEM)을 이용하였다.
브레이크 인 단계가 끝나고 CMP 공정 직전의 연마 패드 표면 상태를 파악하기 위해 재료제거율에 영향을 미치는 기계적 요소 중 하나인 웨이퍼와 패드의 미세 돌기가 접촉하는 실 접촉 면적을 측정하였다.
Fig. 4는 실 접촉 면적 측정에 사용된 장비의 개략도이다. 접촉 면적은 광학 현미경을 이용해 측정하였고, 압력은 실제 연마에 사용되는 210 g/cm
2을 적용하였다. 연마 패드의 크기는 20 × 20mm
2이며, 측정 영역은 7,500 × 8,000 μm
2이다.
Fig. 4Schematic of measuring real contact area between wafer and polishing pad
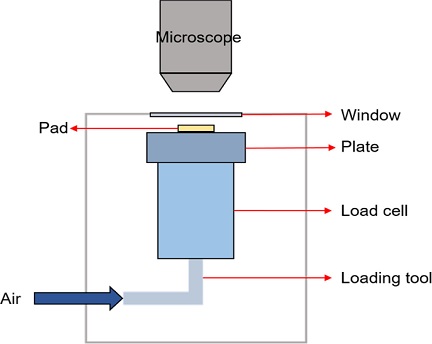
3.2 실험 조건
패드 표면 온도를 올리는 워밍업 단계에 사용되는 웨이퍼 압력에 따라 연마기에 설치된 IR 센서(FT-H30, KEYENCE, Japan)를 이용하여 실시간 패드 표면 온도를 측정하였다. 워밍업 이전의 컨디셔닝은 15분 진행하였으며, 워밍업 조건은
Table 1에 기술하였다. 웨이퍼 압력을 140 g/cm
2부터 350 g/cm
2씩 70 g/cm
2 간격으로 증가하였고, 웨이퍼의 이탈을 방지하기 위한 리테이닝 링의 압력은 210부터 420 g/cm
2까지 가압하였다. 헤드와 정반의 속도는 각각 93, 87 rpm으로 실행하였다. 워밍업에 사용된 웨이퍼는 브레이크 인 지연 현상을 방지하기 위해 200 mm 사이즈의 실리콘 웨이퍼를 사용하였고,
3 각 웨이퍼당 15분씩 가공을 진행하였다. 실제 연마에 사용된 웨이퍼는 200mm 사이즈의 산화막 웨이퍼를 사용하였고, 워밍업 웨이퍼 1회 가공한 뒤 10초 컨디셔닝 후 연마를 진행하였고 패드의 FWU 구간까지 반복하였다. 연마 실험에 대한 조건은
Table 2에 기술하였다. 연마 패드는 KPX사의 KONI 패드를 사용하였고, 연마 장비는 G&P Technology사의 POLI-500 장비를 사용하였다.
Table 1Break-in conditions
Table 1
|
Wafer |
200 mm Si wafer |
|
Pad |
Closed-pore polyurethane pad |
|
Slurry |
Alkaline fumed silica |
Pressure
[g/cm2] |
Head |
140/210/280/350 |
|
Retainer |
210/300/350/420 |
Velocity
[rpm] |
Head |
93 |
|
Platen |
87 |
|
Slurry flow rate [ml/min] |
200 |
|
Conditioning |
Speed
[rpm] |
101 |
Down force
[kgf] |
3 |
Time
[min] |
15 |
Table 2Experimental conditions
Table 2
|
Wafer |
200 mm Oxide wafer |
|
Pad |
Closed-pore polyurethane pad |
|
Slurry |
Alkaline fumed silica |
Pressure
[g/cm2] |
Head |
210 |
|
Retainer |
300 |
Velocity
[rpm] |
Head |
93 |
|
Platen |
87 |
|
Slurry flow rate [ml/min] |
200 |
|
Conditioning |
Ex-situ |
|
Conditioning |
Speed
[rpm] |
101 |
Down force
[kgf] |
3 |
Time
[min] |
15 |
|
Polishing time [min] |
1 |
4. 실험 및 측정 결과
4.1 패드 표면 측정 결과
워밍업 단계에서 패드가 최적화되기까지 걸리는 시간을 파악하기 위해 표면 온도를 측정하였다.
Fig. 5는 웨이퍼 압력에 따른 연마 횟수별 실시간 패드 온도 그래프이다.
Fig. 5Graph of pad surface temperature according to wafer pressure in warming-up
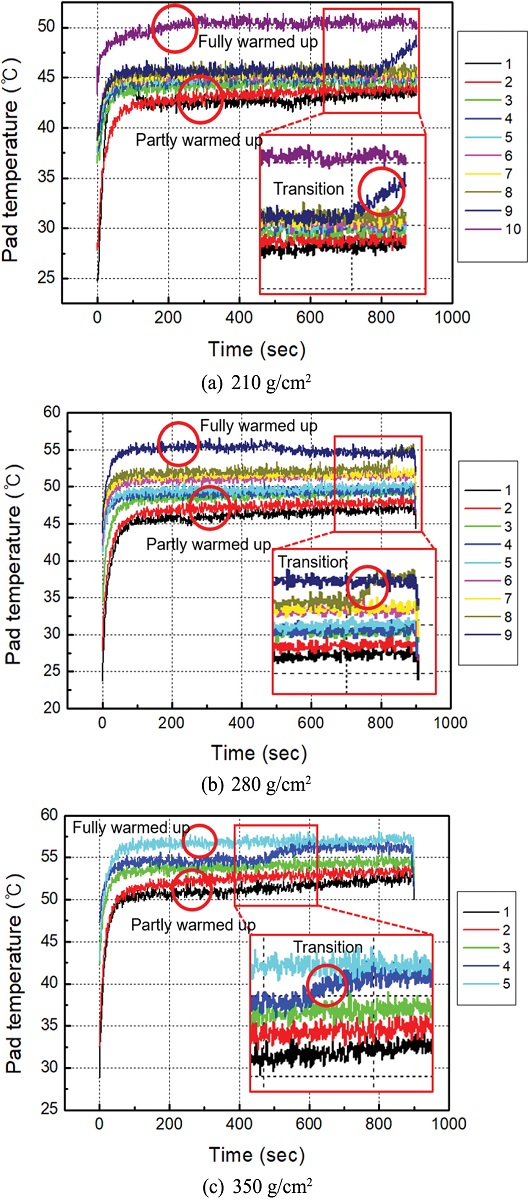
웨이퍼 압력
Fig. 5(a)의 210 g/cm
2에서 FWU 구간으로까지의 걸린 시간은133분이며
Figs. 5(b)와
5(c)에서 압력이 올라갈수록 280 g/cm
2에서 118.6분, 350 g/cm
2에서 52.8분이 소요되고, 천이 구간을 거친 후에 패드는 FWU 상태에 도달하는 것을 패드 온도 그래프에서 알 수 있다. 가장 낮은 압력인 140 g/cm
2에서는 300분 이상 소요되어서 실제 공정에 사용되기에 효율이 떨어진다고 생각되어 제외하였다.
Figs. 6과
8은 각 조건에 대해 컨디셔닝 이전의 FWU 패드 상태의 표면거칠기 Rpk (Reduced Peak Height), Rvk (Reduced Valley Depth)에 대한 그래프이다. FWU 상태와의 비교를 위해 컨디셔닝 이후 및 PWU 상태(210 g/cm
2)의 값을 표기하였으며, 표면 거칠기 Rpk는 중심 거칠기 단면 곡선에서 돌출된 산의 평균 높이에 해당하는 변수로서, 이는 연마 패드의 돌기와 웨이퍼의 실 접촉 면적을 평가할 수 있다. Rvk는 중심 거칠기 단면 곡선에서 골의 평균 깊이를 나타내는 변수로서, 슬러리를 담을 수 있는 연마 패드 표면의 능력에 대한 확인이 가능하다. 표면 거칠기 평가에 많이 사용되는 Ra는 거칠기 프로파일 변화 또는 편차에 민감하지 않은 한계점이 있기 때문에 선정하지 않았다.
13 컨디셔닝만 진행한 패드에서 가장 높은 Rpk값을 가지고 워밍업을 진행하면 세 가지 조건에서 모두 오랜 시간 연마에 의해 FWU 구간에서 표면 거칠기 값이 감소하는 것을 확인할 수 있다. 압력이 210에서 280 g/cm
2로 증가할 때 압력에 의한 돌기의 마모로 인해 표면 거칠기는 감소하고, 280에서 350 g/cm
2으로 증가할 때에는 압력에 의한 마모 효과도 작용하지만
Fig. 7과 같이 온도가 올라가면 패드 돌기의 열 팽창으로 인해 돌기의 각도가 증가하여 표면 거칠기 값은 증가한다.
Fig. 8은 워밍업 조건에 따라 FWU 상태의 탄성 계수 및 경도를 나타낸 그래프이다. 컨디셔닝만 진행한 패드와 비교하였을 때 워밍업을 시행한 패드는 탄성 계수와 경도가 상승한다. 이는 CMP 연마 패드의 종류 중에 탄성 계수와 경도가 낮은 연질 패드가 경질 패드에 비해 재료제거율이 높은 것과 같이
14 브레이크 인을 통해 연마 패드의 탄성 계수 및 경도가 감소하여 마찰력이 오르기 때문에 재료제거율은 상승한다. 각 워밍업 압력별 결과로는 열경화성 고분자인 연마 패드가 온도와 압력에 영향을 받을 때 패드 내의 가교결합이 변화한다. 어느 시점까지는 결합이 끊어지지 않고 외부 작용을 버티기 때문에 탄성 계수 및 경도는 증가하지만 유리전이온도(
Tg)를 넘어서면 고분자 내의 결합이 끊어져 기계적 물성은 감소한다.
15,16
Fig. 6Comparison of surface roughness by conditioning and wafer pressure conditions

Fig. 7SEM images of pad surface according to temperature
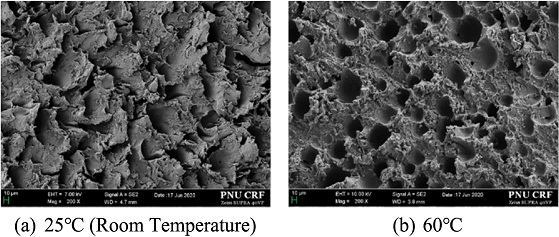
Fig. 8Graph of elastic modulus and hardness of pad asperity
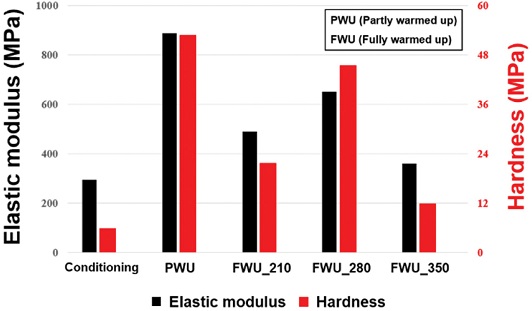
Figs. 9와
10은 브레이크 인 각 단계에 대한 워밍업 압력 210 g/cm
2을 적용하였을 때 연마 패드 표면의 SEM과 Micro-CT(SKYSCAN1272, Bruker-Micro CT, Belgium) 이미지이다.
Figs. 9(a)와
10(a)는 패드 초기의 표면 상태로서 기공들은 보이지만 돌기의 방향성이 없고 제작 및 운반 과정에서 생긴 이물질들이 보인다. 컨디셔닝을 진행한 뒤의 표면인
Figs. 8(b)와
9(b)는 돌기의 방향성이 보이고 높이 편차가 줄어든 것을 확인할 수 있다.
Figs. 8(c)와
8(e)의 이미지는 웨이퍼 연마를 통해 실제로 많이 마모가 된 것을 확인할 수 있고,
Fig. 6의 표면 거칠기 값과 유사한 결과를 볼 수 있다.
Figs. 8(d)와
8(f)는 각각
Figs. 8(c)와
8(e)에서 컨디셔닝 10초를 진행한 연마하기 직전의 연마 패드 상태이며, 컨디셔닝으로 인해 돌기는 다시 재생된다.
Fig. 9(c)는 워밍업이 완료된 후의 표면 이미지이다. 초기 패드 표면에 비해 표면 거칠기의 감소 및 돌기의 마모로 인하여 웨이퍼와 접촉하는 돌기들의 평균 반경은 증가하기 때문에
17 참여 입자들의 수가 늘어나고 마찰 및 온도가 증가하는 원인이 된다.
Fig. 9SEM images of pad surface
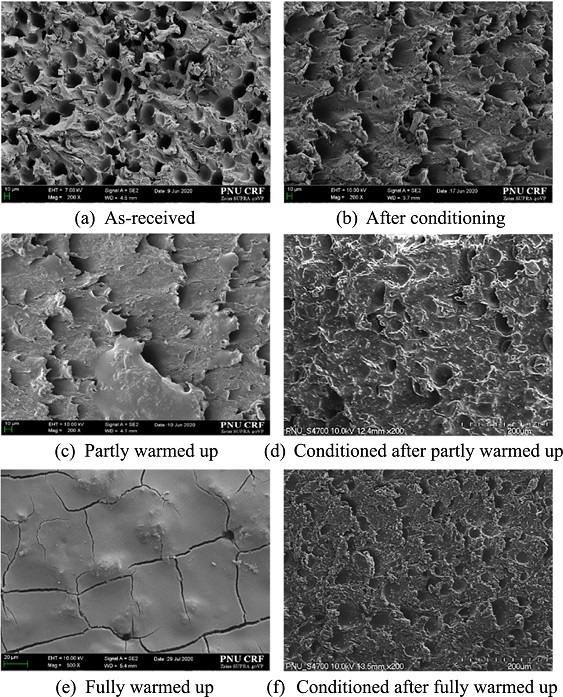
Fig. 10Micro-CT images of pad asperities
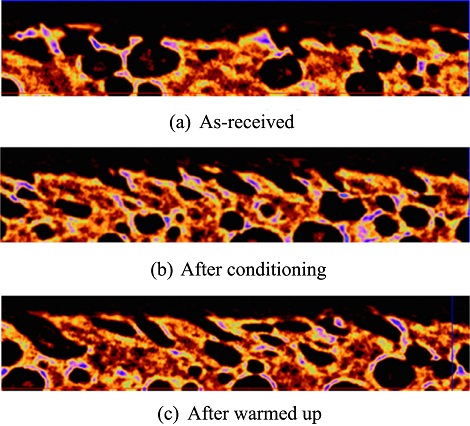
4.2 실 접촉 면적 결과
브레이크 인 단계 이후 실제 CMP 공정 전의 패드 표면의 상태에 대해 재료제거율에 영향을 주는 기계적 요소로 FWU 상태에 대한 연마 패드와 웨이퍼 사이의 실 접촉 면적에 대한 측정 결과이다.
Fig. 11은 패드의 컨디셔닝 이전의 PWU 구간에 대한 실 접촉 면적의 이미지이고,
Fig. 12는 컨디셔닝 이전의 FWU 구간에 도달한 웨이퍼와 패드의 실 접촉 면적 이미지이다. 이미지에 보이는 검은 점들이 웨이퍼와 패드가 접촉하는 패드 돌기를 나타낸다. 측정 결과 PWU 구간에서 각 압력에 대한 실 접촉 면적은 0.6711, 0.8107, 0.5456%이다. 또한, 접촉 점들에 대한 평균 둘레는 335.16, 275.19, 297.73 μm이다. FWU 구간에서 각 압력에 대한 실 접촉 면적은 0.4693, 0.3666, 0.3827%이고, 평균 둘레는 507.66, 408.76, 418.75 μm이다.
Fig. 11Images of real contact area in partly warmed up step
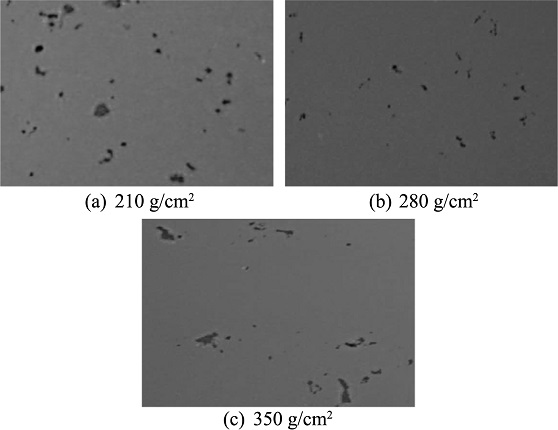
Fig. 12Images of real contact area in fully warmed up step

또한, 앞서 언급한 실 접촉 면적과 웨이퍼와 패드 돌기의 기계적 물성과의 관계
식(2)에 따르면 실 접촉 면적과 탄성 계수는 반비례 관계이다.
Fig. 13은 컨디셔닝 및 워밍업 이후(Light Conditioning 이전)의 패드에 대한 돌기의 탄성 계수와 실 접촉 면적 사이의 관계이다. 브레이크 인이 끝나고 패드의 FWU가 이루어지면
Fig. 13과 같이 반비례 관계를 경향을 나타내었다.
Fig. 13Correlation between elastic modulus and real contact area

Fig. 14는
Figs. 11과
12의 측정 영역 전체에서의 실 접촉 면적과 실 접촉 둘레에 대한 결과이며, FWU 상태와의 비교를 위해 컨디셔닝 이후 및 PWU 상태(210 g/cm
2)에 대한 값을 포함하였다. 연마 패드의 브레이크 인 단계별 및 압력 조건을 거친 패드들에 대해 실제 연마에 사용되는 210 g/cm
2을 적용하여 측정한 결과이다. 패드가 FWU 구간에 들어서면 돌기 높이를 일정하게 만들어주는 컨디셔닝만 진행한 패드의 결과와 유사한 값을 나타내고, FWU 상태의 연마 패드의 실 접촉 면적은 표면 거칠기 Rpk의 경향과 유사한 경향을 보이며, 접촉점들의 평균 둘레는 증가한다. 이는 같은 압력일 때 실 접촉 면적이 작아지면 실 접촉 압력이 증가하고 실 접촉 둘레가 커지면 연마에 참여하는 입자들이 증가하여 마찰의 증가 원인이 될 수 있다.
Fig. 14Graph of real contact area and perimeter for pad state

4.3 실험 결과
브레이크 인 워밍업 단계에서 웨이퍼 압력별 연마 실험의 결과를
Fig. 15에 나타내었다. 워밍업 압력별로 워밍업 웨이퍼 15분, 컨디셔닝 10초 후 같은 조건으로 연마를 1분씩 진행하였다.
Fig. 15에 표시된 마찰력은 워밍업 시 측정된 마찰력이며, 웨이퍼 횟수가 증가할수록 초기에는 마찰력이 증가하다가 이후 마찰력은 정상 상태에 도달하며, 압력이 증가함에 따라 정상 상태에 도달한 마찰력은 높은 값을 나타냈다. 이러한 결과는 실 접촉 둘레가 증가하면서 참여 입자 수가 증가하여 마찰력은 증가하고, 정상 상태 도달 시 마찰력의 크기는 워밍업 웨이퍼 압력에 영향을 받는 것을 알 수 있다. 연마 시 온도는 모든 압력 조건에서 재료제거율과 비슷한 경향을 나타내었으며, 웨이퍼 압력별로 브레이크 인 완료 이전 평균 재료제거율은 170.8, 174.3, 181.6 nm이며, 브레이크 인 완료 이후 평균 재료제거율은 193.7, 194.3, 211.0 nm이다. 재료제거율이 증가하는 이유 중 하나로는
Fig. 8에서와 같이 브레이크 인이 완료되었을 때, 탄성 계수가 감소하면 재료제거율은 증가하는 경향을 가지기 때문이다.
18
Fig. 15Graph of material removal rate (MRR) and friction force according to wafer pressure in warming-up
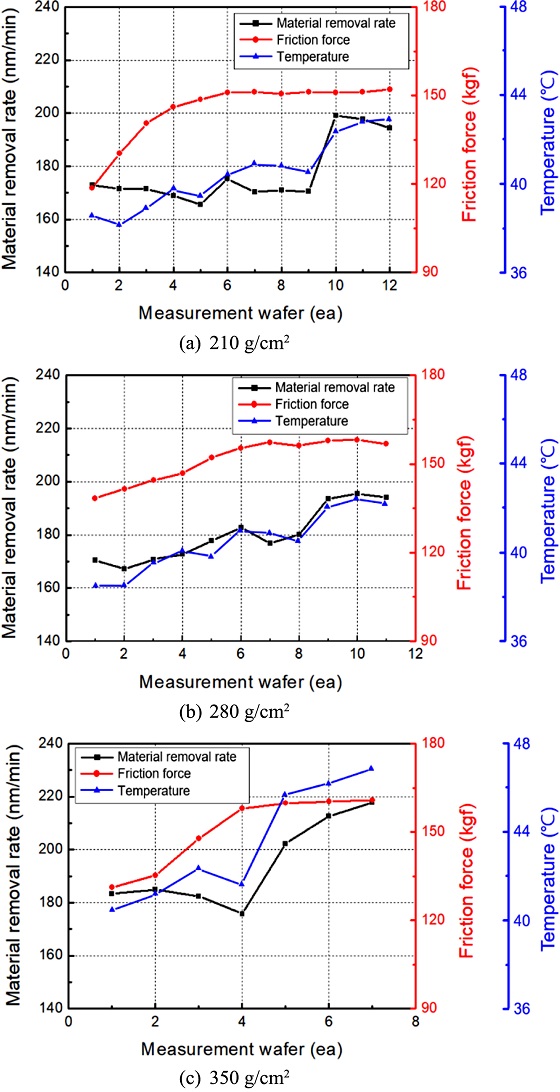
5. 결론
본 연구에서는 실제 CMP 공정 전 연마 패드를 최적의 상태로 만드는 브레이크 인 메커니즘을 파악하였다. 먼저 브레이크 인에 속하는 워밍업 압력 조건에 따른 브레이크 인 도달 시간은 압력이 증가할수록 시간이 줄어듦을 확인하였다. 또한, 워밍업 단계에서 패드는 PWU 구간, 천이 구간, FWU 구간으로 나눌 수 있다. 패드가 FWU 되었을 때의 상태에 대하여 패드 표면 거칠기와 돌기의 기계적 물성 및 웨이퍼와의 실 접촉 면적으로 분석하였고, 모든 압력 조건에서 패드가 FWU 상태가 됨에 따라 표면 거칠기 값은 감소하였다. 연마 패드 돌기의 탄성 계수 및 경도는 PWU 구간에 비해 FWU 구간에서 감소하는 것을 확인하였다. 이러한 감소에 의해 워밍업 중 마찰력이 증가하여 온도가 증가한다. 실제 CMP 공정에서 사용한 웨이퍼 압력인 210 g/cm
2을 적용하여 웨이퍼와 연마 패드의 실 접촉 면적을 측정한 결과, FWU 구간에서 접촉 면적은 줄어들지만, 접촉 평균 둘레는 증가하기 때문에 웨이퍼와 패드 돌기 사이에 머물러있는 연마 입자 개수가 많아져 마찰력이 증가한다.
Fig. 16은 연마 패드의 브레이크 인 메커니즘에 대한 개념도이다. 브레이크 인은 초기 컨디셔닝으로 연마 패드의 돌기 상태를 일정한 높이 및 방향성을 가지게 만들고, 워밍업을 통해 표면 거칠기의 감소 및 기계적 물성의 감소로 마찰력을 증가시켜 온도를 증가시킨다. 이후, 짧은 컨디셔닝으로 마모된 돌기를 재생시켜주어 실제 CMP 공정에 적합한 패드 상태로 만들어준다.
Fig. 16 Schematics of break-in mechanism based on polishing pad asperities
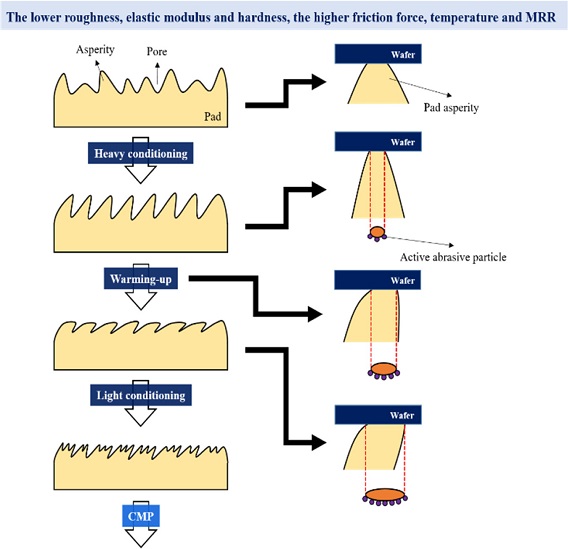
브레이크 인 단계에서 연마 패드의 PWU 구간과 FWU 구간에서의 연마 패드 상태에 대해 확인하였으며 재료 제거율에 미치는 영향을 고찰하였다. 연마 장비 및 외부 환경 조건에 따라 FWU 도달 시간은 다를 것이다. 따라서 브레이크 인 중 연마 패드 샘플을 준비하여 표면 거칠기 및 기계적 물성의 변화, 실 접촉 면적을 확인하는 방법과 워밍업 중 마찰력의 증가 및 안정화, 온도의 증가 및 안정화를 확인하여 연마 패드의 FWU 상태를 예측 가능 할 것으로 판단된다.
ACKNOWLEDGMENTS
이 논문은 2020년도 정부(미래창조과학부)의 재원으로 한국연구재단의 지원을 받아 수행된 연구임(No. NRF-2019R1A2B5B01070489).
REFERENCES
- 1.
Lai, C. L. and Lin, S. H., “Electrocoagulation of Chemical Mechanical Polishing (CMP) Wastewater from Semiconductor Fabrication,” Chemical Engineering Journal, Vol. 95, Nos. 1-3, pp. 205-211, 2003.
10.1016/S1385-8947(03)00106-2
- 2.
Wang, C., Sherman, P., Chandra, A., and Dornfeld, D., “Pad Surface Roughness and Slurry Particle Size Distribution Effects on Material Removal Rate in Chemical Mechanical Planarization,” CIRP Annals, Vol. 54, No. 1, pp. 309-312, 2005.
10.1016/S0007-8506(07)60110-3
- 3.
Jeong, H., Park, K., and Cho, K., “CMP Pad Break-In Time Reduction in Silicon Wafer Polishing,” CIRP Annals, Vol. 56, No. 1, pp. 357-360, 2007.
10.1016/j.cirp.2007.05.082
- 4.
Park, K., Park, J., Park, B., and Jeong, H., “Correlation between Break-In Characteristics and Pad Surface Conditions in Silicon Wafer Polishing,” Journal of Materials Processing Technology, Vol. 205, Nos. 1-3, pp. 360-365, 2008.
10.1016/j.jmatprotec.2007.11.203
- 5.
Park, K. and Jeong, H., “Investigation of Pad Surface Topography Distribution for Material Removal Uniformity in CMP Process,” Journal of the Electrochemical Society, Vol. 155, No. 8, pp. H595-H602, 2008.
10.1149/1.2938378
- 6.
Vasilev, B., Bott, S., Rzehak, R., and Bartha, J. W., “Pad Roughness Evolution during Break-In and Its Abrasion due to the Pad-Wafer Contact in Oxide CMP,” Microelectronic Engineering, Vol. 111, pp. 21-28, 2013.
10.1016/j.mee.2013.04.027
- 7.
Kim, H., Kim, H., Jeong, H., Lee, E., and Shin, Y., “Friction and Thermal Phenomena in Chemical Mechanical Polishing,” Journal of Materials Processing Technology, Vols. 130-131, pp. 334-338, 2002.
10.1016/S0924-0136(02)00820-8
- 8.
Moon, Y., “Mechanical Aspects of the Material Removal Mechanism in Chemical Mechanical Polishing (CMP),” Ph.D. Thesis, University of California, 1999.
- 9.
Kim, H., Kim, H., and Jeong, H., “Study on Pad Properties as Polishing Result Affecting Factors in Chemical Mechanical Polishing,” Journal of the Korean Society for Precision Engineering, Vol. 17, No. 3, pp. 184-191, 2000.
- 10.
Qin, K., Moudgil, B., and Park, C. W., “A Chemical Mechanical Polishing Model Incorporating both the Chemical and Mechanical Effects,” Thin Solid Films, Vol. 446, No. 2, pp. 277-286, 2004.
10.1016/j.tsf.2003.09.060
- 11.
Greenwood, J. A. and Williamson, J. P., “Contact of Nominally Flat Surfaces,” Proceedings of the Royal Society of London. Series A: Mathematical and Physical Sciences, Vol. 295, No. 1442, pp. 300-319, 1966.
10.1098/rspa.1966.0242
- 12.
Lee, H., “Semi-Empirical Material Removal Model with Modified Real Contact Area for CMP,” International Journal of Precision Engineering and Manufacturing, Vol. 20, No. 8, pp. 1325-1332, 2019.
10.1007/s12541-019-00161-6
- 13.
Kim, H. J., Jeong, H. D., Lee, E., and Shin, Y., “Pad Surface Characterization and Its Effect on the Tribological State in Chemical Mechanical Polishing,” Key Engineering Materials, Vols. 257-258, pp. 383-388, 2004.
10.4028/www.scientific.net/KEM.257-258.383
- 14.
Yang, J. C., Choi, J. H., Hwang, T., Lee, C. G., and Kim, T., “Effects of Diamond Size of CMP Conditioner on Wafer Removal Rates and Defects for Solid (Non-Porous) CMP Pad with Micro-Holes,” International Journal of Machine Tools and Manufacture, Vol. 50, No. 10, pp. 860-868, 2010.
10.1016/j.ijmachtools.2010.06.007
- 15.
Cheremisinoff, N. P., “Condensed Encyclopedia of Polymer Engineering Terms,” Butterworth-Heinemann, p. 74, 2001.
10.1016/B978-0-08-050282-3.50022-6
- 16.
Seo, J. W., Yun, S. H., Jeong, E. S., Lee, J. N. and Seo, J. W., “The Study of Surface on CMP Pad and CMP Performance by Fragmented Polymer Structure,” Proc. of the Korean Tribology Society Conference, pp. 87-88, 2019.
- 17.
Kim, H., “A Study on the Interfacial Characteristics and Its Effect on Material Removal in CMP,” Ph.D. Thesis, Pusan National University, 2003.
- 18.
Bajaj, R., Desai, M., Jairath, R., Stell, M., and Tolles, R., “Effect of Polishing Pad Material Properties on Chemical Mechanical Polishing (CMP) Processes,” MRS Online Proceedings Library Archive, Vol. 337, pp. 637-644, 1994.
Biography
- Kyeongwoo Jeong
He received the M.S. degree in the Department of Mechanical Engineering, Pusan National University. His research interest is reduction of break-in time.
- Seonho Jeong
Ph.D. candidate in the Department of Mechanical Engineering Pusan National University. His research interest is modeling of pad condition.
- Somin Shin
She received the M.S. degree in the Department of Mechanical Engineering, Pusan National University. Her research interest is mathematical modeling of planarization with pad asperity property in CMP.
- Jinuk Choi
He received the M.S. degree in the Department of Mechanical Engineering, Pusan National University. His research interest is pad temperature control.
- Haedo Jeong
Professor in the Department of Mechanical Engineering, Pusan National University. His research fields include chemical mechanical polishing (CMP), grinding, polisher and consumable design, and post-CMP cleaning.